IHR ANSPRECHPARTNER
Frank Thielert
info@confovis.com
Tel: +49 3641 27 410 – 00
- Schnell und nanometergenau
- Flexibel
- Hohe Automatisierung
Umfassende 3D-Fehler- und Anomalieinspektion für die Inline-Halbleiterfertigung.
Das WAFERinspect AOI Dual ist ein AOI-System, das mit zwei High-End-Sensoren für Inspektionsaufgaben in der Halbleiterfertigung ausgestattet ist. Die beiden Sensoren ermöglichen eine Inspektion von Wafern bis zu 300 mm in einem Zwei-Wege-Verfahren. Es wurde speziell für die Inspektion von Linsen und Bumps in LiDAR und Advanced Packaging Anwendungen entwickelt. Zunächst wird der gesamte Wafer innerhalb weniger Minuten gescannt, um Defekte zu identifizieren. Dann werden die betreffenden Strukturen mit dem ConfoCam-Modul auf nm-Genauigkeit analysiert.
Sie sehen gerade einen Platzhalterinhalt von Vimeo. Um auf den eigentlichen Inhalt zuzugreifen, klicken Sie auf die Schaltfläche unten. Bitte beachten Sie, dass dabei Daten an Drittanbieter weitergegeben werden.
Mehr InformationenDas WAFERinspect AOI Dual kann einen vollständigen 3D-Scan eines 300 mm Wafers innerhalb von 2 bis 3 Minuten durchführen, was eine schnelle 3D-Fehlerprüfung ermöglicht. Das Tool eignet sich besonders für die Inspektion von Mikrolinsen und Bumps, zum Beispiel bei LiDAR und Advanced Packaging Anwendungen.
Die Kombination von zwei nebeneinander liegenden Sensoren ermöglicht einen Zwei-Pfad-Ansatz: So können in einem zweiten Pfad die betreffenden Strukturen mit dem patentierten optischen Messverfahren von Confovis nanometergenau analysiert werden.
Strukturhöhen von 50 µm bis zu wenigen mm können mit dem 1200 Punkte fassenden Weißlichtsensor nahtlos vermessen werden.
Unabhängig davon, ob es sich um Verformungen von Mikrolinsen für LiDAR oder um Höhenverteilungen von Unebenheiten im Advanced Packaging handelt, kann das WAFERinspect AOI Dual eine 100%ige 3D-Defektinspektion auf großen Datenmengen von bis zu 1 TB/Wafer durchführen.
Die KI-Fähigkeit von Confovis bei der Erkennung von Anomalien ermöglicht ebenso die Detektion unbekannter Defekte. Zusätzlich ist ein Vergleich zwischen der tatsächlichen Form der Strukturen und einem Target (Golden Sample) möglich.
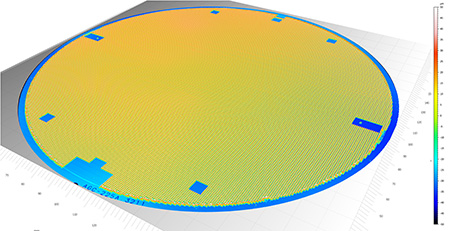

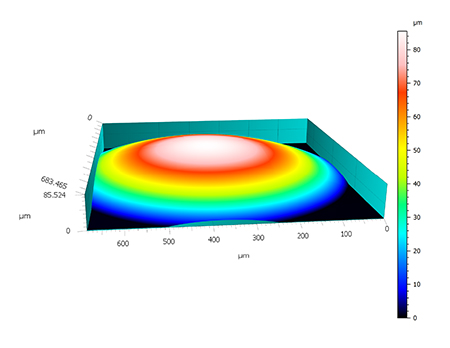
WAFERInspect AOI Dual: Applikationen
Melden Sie sich jetzt für unseren Newsletter an und erhalten Sie exklusiven Zugang zu unserem Whitepaper.
Unser Newsletter informiert Sie regelmäßig über die neuesten Branchentrends, Events, Produktankündigungen und exklusive Angebote. Seien Sie immer auf dem Laufenden und profitieren Sie von wertvollen Informationen, die Ihr Unternehmen voranbringen können.

SIE SUCHEN NACH EINER LÖSUNG FÜR IHRE APPLIKATION?
KONTAKTIEREN SIE UNS!
Frank Thielert
info@confovis.com
Tel: +49 3641 27 410 – 00

Sie müssen den Inhalt von reCAPTCHA laden, um das Formular abzuschicken. Bitte beachten Sie, dass dabei Daten mit Drittanbietern ausgetauscht werden.
Mehr InformationenSie müssen den Inhalt von reCAPTCHA laden, um das Formular abzuschicken. Bitte beachten Sie, dass dabei Daten mit Drittanbietern ausgetauscht werden.
Mehr Informationen