IHR ANSPRECHPARTNER
- Schnell und nanometergenau
- Flexibel
- Hohe Automatisierung
Kombiniert automatische optische Inspektion und Metrologie für Serieninspektions- und Messaufgaben
Das Confovis WAFERinspect AOI System kombiniert verschiedenste Inspektionsaufgaben an strukturierten und unstrukturierten Wafern in nur einem System. Durch die Kombination von automatischer optischer Inspektion (AOI) und Metrologie bietet Confovis AOI Lösungen für Defect Inspection und Classification sowie 3D- und 2D-Messungen (Wafer Level Metrology) für MEMS, Advanced Packaging, RDL, Bumps, etc.
Sie sehen gerade einen Platzhalterinhalt von Vimeo. Um auf den eigentlichen Inhalt zuzugreifen, klicken Sie auf die Schaltfläche unten. Bitte beachten Sie, dass dabei Daten an Drittanbieter weitergegeben werden.
Mehr InformationenBei der Defect Inspection werden die Defekte auf den Wafern während des Scans durch die Golden Sample Methode erkannt und klassifiziert. Der entsprechende Klassifikator arbeitet mittels künstlicher Intelligenz merkmalsbasiert und bildbasiert und wird durch den Nutzer mit den Eigenschaften der gefundenen Defekte in Zugehörigkeit zu den entsprechenden Klassen trainiert. Dadurch ist vor dem Defect Scan kein Teaching der Defekte erforderlich und das System findet eigenständig die Abweichungen zwischen Golden Sample und dem Defect Scan.

Neben dem Defect Scan ermöglicht das von Confovis patentierte konfokale Messverfahren Structured Illumination Microscopy materialunabhängige und nanometergenaue Flächenscans mit 60 konfokalen Frames/Sekunde. Die Messungen erfolgen typischerweise in zwei Sekunden (120 Messebenen mit einem z-Bereich von 20 µm und einer Genauigkeit von < 4 nm), mit einem Messergebnis unabhängig vom Material der zu messenden Oberfläche. Auch schwierigste Kombinationen aus Passivierungsschichten und Kupfer können problemlos und ohne Vorwissen gemessen werden.
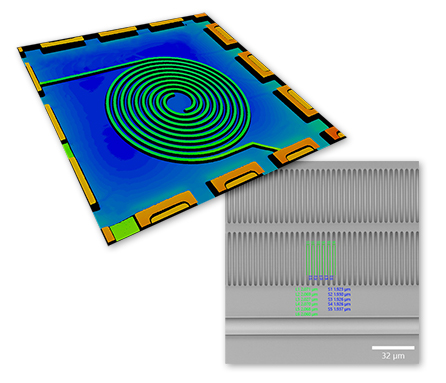
Die Wafer Inspect Software von Confovis bietet dem Nutzer durch Kombination von Easy Modes und Advanced Modes eine einfache Handhabung mit maximaler Flexibilität in der Auswertung durch „Geometry measurements“. Rezepte können in weniger als fünf Minuten erstellt werden. Die Defekterkennung und -auswertung erfolgt mit der vollständig integrierten und anpassbaren Software unseres Partners NeuroCheck.
WAFERinspect AOI in der Anwendung
WAFERinspect AOI Messaufgaben

SIE SUCHEN NACH EINER LÖSUNG FÜR IHRE APPLIKATION?
KONTAKTIEREN SIE UNS!

Sie müssen den Inhalt von reCAPTCHA laden, um das Formular abzuschicken. Bitte beachten Sie, dass dabei Daten mit Drittanbietern ausgetauscht werden.
Mehr InformationenSie müssen den Inhalt von reCAPTCHA laden, um das Formular abzuschicken. Bitte beachten Sie, dass dabei Daten mit Drittanbietern ausgetauscht werden.
Mehr Informationen