YOUR CONTACT PERSON
Frank Thielert
info@confovis.com
Tel: +49 3641 27 410 – 00
- Fast and with nanometer precision
- Flexible
- High level of automation
Combined automated optical inspection and metrology for serial inspection and measuring tasks
WAFERinspect AOI
The Confovis WAFERinspect AOI system combines the most diverse inspection tasks involving structured and unstructured wafers in just one system. By combining automated optical inspection (AOI) and metrology the Confovis WAFERinspect AOI offers individual solutions for defect inspection and classification as well as for 3D and 2D measurements (wafer level metrology) for MEMS, advanced packaging, RDL, bumps etc.
You are currently viewing a placeholder content from Vimeo. To access the actual content, click the button below. Please note that doing so will share data with third-party providers.
More Information
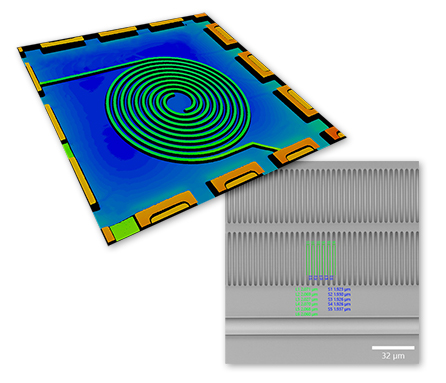
The Wafer Inspect software from Confovis ensures simple handling for the user by combining easy with professional modes, thus offering a maximum of assessment flexibility by way of „geometry measurements“. Formulas can be created within less than five minutes. Defects will be detected and assessed with the fully integrated and adaptable software from our partner NeuroCheck.
Critical Dimensions
Sign up now for our newsletter and gain exclusive access to our whitepaper.
Our newsletter will keep you updated on the latest industry trends, events, product announcements, and exclusive offers. Stay informed and benefit from valuable information that can propel your business forward.
ARE YOU LOOKING FOR A SOLUTION FOR YOUR APPLICATION?
CONTACT US!
Frank Thielert
info@confovis.com
Tel: +49 3641 27 410 – 00